Efecto de la potencia de RF en diversos parámetros de la película μc-Si:H en el proceso PECVD
Células solares HJT han logrado contacto de pasivación en las superficies frontal y posterior, por lo que han obtenido un voltaje de circuito abierto más alto, que es significativamente mayor que el de las células TOPCon y PERC. Sin embargo, hay una absorción parasitaria grave en la capa de silicio amorfo En la superficie frontal, lo que evita que las celdas HJT sean dominantes en la corriente de cortocircuito. Una de las ideas para resolver este problema es usar Silicio microcristalino en lugar de silicio amorfo. Desde el punto de vista del proceso, la formación de silicio microcristalino requiere cambiar La tasa de dilución de silano e hidrógeno, la potencia de RF y la presión de deposición. Para mejorar la tasa de cristalización de película de silicio microcristalino.
Según las diferencias en la estructura cristalina, materiales de película delgada de silicio se puede dividir en Película delgada de silicio monocristalino, película delgada de silicio policristalino y Película delgada de silicio amorfo.

Diagrama esquemático de la estructura del silicio monocristalino, silicio policristalino y silicio amorfo.
Silicio amorfo (a-Si:H) iUn material maduro que se ha utilizado ampliamente en el desarrollo de células solares de película delgada de gran área y transistores de película delgada (TFT) en los campos de la fotovoltaica y la microelectrónica. Sin embargo, debido al orden corto de sus átomos, este orden se relaciona principalmente con la longitud y el ángulo de enlace del enlace covalente. El ángulo de enlace solo se mantiene entre los átomos más cercanos. Por lo tanto, el a-Si:H presenta malas propiedades de transporte, baja movilidad electrónica, alta densidad de enlaces colgantes y se degrada bajo la irradiación luminosa. (Efecto Staebler-Wronski).
Silicio policristalino (poli-Si) Tiene buenas propiedades de transporte, pero la alta temperatura de deposición (600 °C) requerida limita su integración en vidrio y sustratos flexibles.
Película de silicio microcristalino μc-Si:H
Silicio microcristalino μc-Si:H es un Película de silicio fabricada mediante PECVD a baja temperatura (≤200 °C). A diferencia del silicio amorfo y el silicio policristalino, el silicio microcristalino μc-Si:H crece en columnas cristalinas con diferentes orientaciones, separadas por límites compuestos de silicio amorfo.
MEl silicio microcristalino μc-Si:H tiene una banda prohibida y un coeficiente de absorción diferente del silicio amorfo, con mayor conductividad, mayor capacidad de absorción de infrarrojos y mayor estabilidad a la radiación solar (absorción de luz). Por otro lado, el μc-Si:H se deposita en baja temperatura (200℃) y también muestra Alta movilidad de portadores, alta estabilidad y alta conductividad.
Normalmente, las películas de μc-Si:H se fabrican a partir de una mezcla de monosilano (SiH4) y el hidrógeno (H2), pero también puede fabricarse a partir de una mezcla de monosilano (SiH4), hidrógeno (H2) y argón (Ar). Los principales parámetros para la fabricación de películas de μc-Si:H son H2 dilución, Potencia de RF moderada y alta presión de deposición. Al optimizar estos parámetros, la tasa de cristalización Xc Se puede aumentar y optimizar sus características de rendimiento.
Efecto de la potencia de RF sobre el espesor, la tasa de deposición, la rugosidad de la superficie y la tasa de cristalización Xc de películas de silicio microcristalino
Mediante el estudio de las películas de μc-Si:H depositadas a 200°C en un reactor PECVD con diferentes RF potencias (20, 25, 30, 35, 40, 45 W) durante 30 minutos, descubrimos que las diferentes potencias de RF tenían un cierto efecto en la película. espesor, tasa de deposición, rugosidad superficial, tasa de cristalización Xc y otras características.
Datos sobre el efecto de diferentes potencias de RF en el espesor, la tasa de deposición, la rugosidad de la superficie y la tasa de cristalización Xc de películas de μc-Si:H

La tasa de deposición se calcula a partir de el espesor medio de la película y el tiempo de deposición. La siguiente figura muestra la tasa de deposición en función de la potencia de RF. Se observa que la tasa de deposición disminuye al aumentar la potencia de RF.
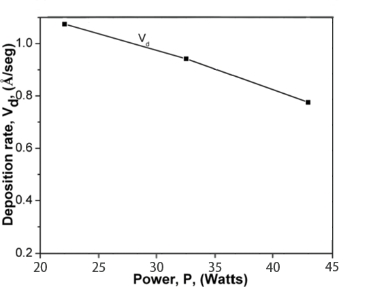
Tasa de deposición de μPelículas delgadas de c-Si:H y relación con la potencia de RF
Está claro que la rugosidad de las películas aumenta a medida que aumenta la potencia de RF para depositar las películas. Según la literatura, los valores de rugosidad más altos en μLas películas de c-Si:H se asocian con tamaños más grandes tamaño del cristal.
La siguiente figura muestra imágenes en 3D de μPelículas de c-Si:H depositadas con diferentes potencias de RF. A partir de las mediciones, extrajimos... la rugosidad media (Sa) y rugosidad cuadrática media Valores (RMS).

Análisis Raman
Espectroscopia Raman poder utilizarse para caracterizar μPelículas delgadas de c-Si:H. La siguiente figura muestra los espectros Raman de las películas depositadas a diferentes niveles de potencia de RF. Un pico distintivo a 520 cm-1 En el espectro se puede encontrar un Xc de cristalización de todas las muestras en el rango del 64-75%, y las películas depositadas a una potencia de RF de 25 W presentan el Xc de cristalización máximo.
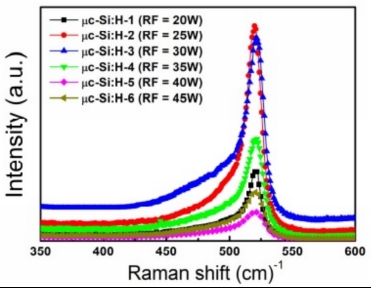
Para la deposición de μc-Si:H, se requieren tres condiciones. Durante la deposición, el H2 Se produce un proceso de grabado. El efecto de una mayor potencia de RF promueve la H2 proceso de grabado, que afecta la cristalinidad Xc de la película.
¿Por qué medir la espectroscopia Raman?
Espectroscopia Raman se utiliza para medir y evaluar la tasa de cristalización de películas delgadas basadas en silicio. Raman es una técnica de dispersión de luzCuando la luz incidente de alta intensidad de una fuente láser es dispersada por una molécula, la mayor parte de la luz dispersada tiene la misma longitud de onda que el láser incidente; esta dispersión se denomina Dispersión de Rayleigh (dispersión elástica)Sin embargo, hay una porción muy pequeña (aproximadamente 1/109) de la luz dispersa que tiene una longitud de onda diferente de la luz incidente, y cuyos cambios de longitud de onda están determinados por la estructura química de la muestra de prueba (la llamada sustancia dispersante), y esta porción de la luz dispersa se llama Dispersión Raman (dispersión inelástica).

Para películas preparadas mediante diferentes parámetros de proceso, la espectroscopia Raman puede comprender La microestructura y el efecto de pasivación de películas de silicio, y determinar la conductividad de la película caracterizando la cristalinidad de la película para proporcionar una dirección de optimización para la preparación de películas de alta calidad.